物联网已被视为大陆IC产业重要热点,然而,IoT或穿戴式装置主要核心架构是将低功耗MCU、eNVM、Analog & PM IC,及无线与连接芯片加以整合,再连接Sensor。DIGITIMES Research认为,IoT或穿戴式装置对IC制造业技术发展而言,多数芯片不需要20奈米,甚至16/14奈米等先进制程,反而是希望在低功耗、芯片整合、传感器等特殊制程能够提供完整解决方案。
大陆晶圆代工龙头中芯国际除持续在先进制程投入研发外,也加强对eNVM、MEMS、PM IC、CIS等特殊制程研发与产能扩充,采取特殊制程与先进制程并重的策略。此外,中芯国际为强化芯片整合技术与生产能力,甚至兴建M1厂,主要建立晶圆级封装、MEMS封装、8吋晶圆Bumping等先进或特殊封测产能。综合中芯国际、武汉新芯、华虹宏力等大陆主要晶圆代工厂于特殊制程发展方向,eNVM、MEMS、Analog & PM IC将是特殊制程的重要技术领域。
封装测试厂方面,IC面积极小化、多芯片封装、低功耗与效能并重仍为重要技术发展方向,其中,大陆封测龙头长电科技除规划将于2015年推出3层MIS基板,让MIS封装技术能够支应更多复杂的IC产品外,并将MIS封装技术延展至PoP封装,推出MIS-PoP,将MIS引导入芯片堆栈的封装领域,2016~2018年更将进一步推出被动组件内嵌基板的技术。
日月光除将SiP技术更进一步提升,推出SiP Module、Embedded SiP、Wefer Level SiP等3种封装技术外,更在兼顾微型化与高效能的要求下,推出HB 与FO SoC等2种技术。总体观察,芯片内埋的嵌入式技术、FO SoC & FO PoP,与铜柱凸块技术,将会是大陆封装测试产业于IoT市场重要技术发展方向。

物联网(Internet of Things;IoT)已被视为下个阶段驱动大陆IC产业成长的重要动能,也成为各主要大陆与台湾IC製造业者的兵家必争之地。然而,无论IoT或穿戴式装置对IC製造产业技术发展而言,主要核心架构是将低功耗MCU、嵌入式挥发性记忆体、类比IC、电源管理IC,及无线与连接晶片加以整合,再连接感测器。
就晶圆代工製程技术角度观察,IoT或穿戴式装置,除智慧型手机与平板电脑等行动装置所搭载AP、GPU、BB等核心晶片会对28奈米、20奈米,乃至16/14奈米等先进製程有强烈需求外,事实上,包括智慧手表、智慧手环等装置,所需要製程多为55奈米以上,甚至是微米级製程,主要需求是在低功耗、晶片整合、感测器、类比与电源管理等特殊製程能提供完整解决方案。
就客户端角度观察,IC製造业则需具备高客製化与整体系统设计能力,同时能够满足异质整合、即时上市、低功耗与极小化、低成本等要求。
大陆晶圆代工龙头中芯国际除持续在先进製程技术上投入研发,并宣布将于2015年上半将28奈米製程导入量产,并投入14奈米FinFET製程研发外,并将加强对eNVM、电源管理IC、CMOS Image Sensor(CIS)、MEMS、RF SOI,乃至硅穿孔(Through Si Via;TSV) 3D IC等特殊製程研发,甚至跨入后段製程凸块(Bumping)服务与晶圆级晶片规模封装技术等方向的研发。
中芯的eFlash採55奈米製程,在2014年6月就已开始量产,代工产品为SIM卡,另外,还开发出55奈米製程LL Platform,与大陆其他仅拥有8吋晶圆厂的晶圆代工业者eFlash主流製程仍停留在0.13微米製程相较,中芯55奈米製程eFlash用于MCU製造将相对具备成本竞争力。
此外,在看好行动运算与巨量资料对NAND Flash的需求,中芯国际也将投入38奈米製程NAND Flash研发与量产。
在MEMS研发方面,中芯的加速度器与MEMS麦克风将于2015年第2季进入风险量产,陀螺仪与压力感测器则预计于第4季进入风险量产。中芯还规划包括RF MEMS、微投影MEMS、生物感测MEMS等MEMS产品的製造技术也将持续投入研发并导入量产,在CIS方面,中芯也推出800万画素 FSI与BSI。
事实上,中芯国际推出採0.18微米製程指纹辨识装置及同样採0.18微米製程MEMS压力感测计,并宣布将于2015年第2季加速度计将进入风险生产阶段,显示中芯国际在特殊製程方面已有相当成就。
与台积电相同,中芯也投入后段封装领域,除与江苏长电合资设立新公司建立28奈米製程Bumping产能,并入股江苏长电併购新科金朋一案外,中芯亦设立M1厂,该厂主要建立晶圆级封装、MEMS封装、8吋晶圆Bumping、CIS/BSI封装等先进或特殊封测产能,亦投入TSV技术研发。
同样拥有12吋晶圆产能的武汉新芯,从产品与技术平台分类,将朝记忆体、55奈米製程低功耗与超低功耗、3D IC,及CIS等4个领域发展。在记忆体方面,除规划将于2016年NOR Flash代工製程由原本45奈米製程升级至32奈米製程并导入量产外,武汉新芯亦鑑于NOR Flash市场的逐渐萎缩,亦将投入3D电晶体结构的V-NAND及次世代记忆体RRAM与MRAM的研发,根据武汉新芯技术蓝图规划,3D NAND Flash将于2018年导入量产。
在CIS方面,武汉新芯推出BIS背照式影像传感器,显示在CIS製程技术研发上取得成果。
在非记忆体微缩製程研发上,武汉新芯也瞄准未来IoT、行动运算的市场,推出55奈米製程低功耗与超低功耗平台,锁定逻辑IC、RF、eFlash等产品线进行代工,但中芯国际及其他国际级晶圆代工厂在逻辑IC及RF製程皆已跨入40奈米製程,甚至28奈米製程,武汉新芯在製程技术明显落后许多,也因此,在逻辑产品代工技术发上,将不会是武汉新芯的发展重心。
此外,在IoT市场将朝多晶片整合方向发展的情况下,武汉新芯也将投入TSV 3D IC技术研发,未来将朝向Wireless、MCU、Flash、Sensor等晶片的整合。
华虹宏力虽仅拥有8吋晶圆产能,但也以eFlash与电源管理等特殊製程核心技术,锁定IoT及智慧家庭等应用市场推出多款代工产品,其中,包括採0.18微米製程智慧电表控制IC、0.13/0.15微米製程RF CMOS IC、0.13微米製程eFlash NFC与eFlash Touch控制IC、0.13微米製程智慧手环控制IC、0.18微米eOPT/eMTP,主要应用于射频身份证辨识器。
由华虹宏力所推出产品观察,在华虹NEC与宏力合併后,eFlash即成为该公司核心技术,为因应IoT产品低功耗需求,也将会将主要製程由0.13微米升级至0.11微米。
此外,华虹宏力也在MEMS技术发展有所成就,除2013年即已拥有压力感测器外,今年亦新推出磁力感测器。除在IoT应用外,华虹宏力亦在固态照明应用与功率元件持续投入研发,分别推出0.35微米製程LED BCD及1700V~6500V IGBT代工服务。
由华虹宏力所推出各类代工产品与解决方案加以分类,该公司透过建立eFlash MCU、eFlash Smart Card、PM IC、MEMS、RF与无线等5大技术平台进行研发,目标也是锁定未来IoT市场的庞大商机。
大陆封装测试龙头长电科技虽仍以导线架封装的MIS(Molded Interconnect System)封装技术为主推技术,该技术主要是透过电镀方式将电路镀在导线架上,并透过可曲折的打线技术,得以简化IC设计与封装设计难度,并能缩小封装后IC面积,MIS技术亦能搭配多晶片模组、QFN、BGA、CSP等封装技术进行封装,也能应用在RF模组封装上。
2014年长电科技透过电镀技术,推出2层电路的导线架,以因应SoC或晶片堆叠导致IC电路複杂化的技术态势。长电科技更预估将于2015年进一步推出3层电路的导线架产品,让MIS封装技术得应支应更加複杂SiP或PoP的封装产品。
除MIS技术外,长电科技亦推出採硅穿孔(Through Si Via;TSV)3D IC技术的指纹辨识封装解决方案。
先由IC设计客户端提供触控萤幕控制IC及指纹辨识ID感测器,再由长电科技子公司江阴长电(JCAP)进行沟漕式重佈线层的硅穿孔,之后再由长电科技将感测器与控制IC以SiP Module技术进行封装,最后再交货予客户。事实上,长电科技指纹辨识封装方案已在为华为手机进行代工与量产。
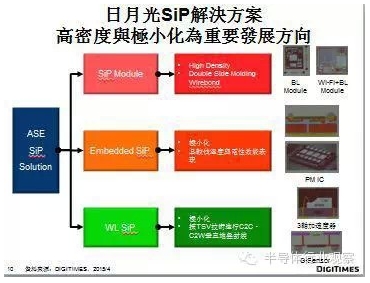
相对于陆厂进展,在大陆市场深耕已久的日月光则是针对多晶片封装、微小化与低功耗、低功耗等产品要求,以SiP技术更进一步提升,推出SiP Module、Embedded SiP、Wefer Level SiP等3种封装技术。
其中,SiP Module是透过两面模造(Double Side Molding)方式,提高表面构装技术(Surface Mount Technology;SMT)密度,主要可应用在电源管理IC、蓝牙+WiFi等无线晶片的封装。
Embedded SiP则是透过将被动元件或晶片内埋至基板的方式,使得SiP模组得以极小化,并具备较佳温度与电性表现。值得一提的是,不仅仅是被动元件,日月光能够同时内理1颗控制晶片再加2颗电源管理晶片,得以让整个SiP模组面积进一步缩小。
有别于Embedded SiP,Wefer Level SiP则是透过晶圆级封装技术,以C2C或C2W垂直堆叠方式进行封装,以达到SiP模组极小化的目的,该技术最适用于MEMS感测器与控制晶片的封装。
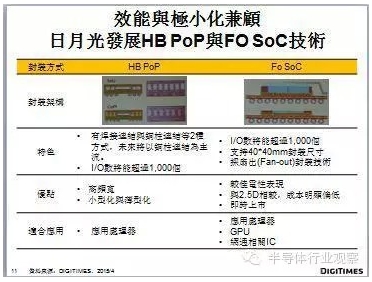
除追求低功耗与极小化外,对于效能兼顾也是封测厂重要课题之一,尤其随行动装置所搭载记忆体容量持续攀升,再加上记忆体传输速度也大幅提高,而行动装置所搭载AP效能也往持续提升方向发展,为此,日月光还推出HB PoP(High Bandwidth PoP)与FO SoC等2种技术。
HB PoP技术主要透过铜柱(CuPI)或焊合(SeLI)等两种技术,大幅提高I/O数目,该技术优点除频宽大幅提升外,以铜柱取代打线或锡球接合的方式,能够让PoP更加小型化与薄型化。至2015年3月,I/O数已达560个,日月光规划至2016年I/O数目将能提升超过1,000个,到时IC效能将能进一步提升。
著眼于採用硅中介层(Si Interposer)的2.5D封装技术成本太高,但又要维持传输效应的考量,日月光也与台积电相同,推出扇出(FO )SoC封装技术,与扇入(Fan in)技术相较,FO SoC的I/O数大幅提升,进而带动效能明显改善,成本更较2.5D封装技术大幅下降,该技术最主要应用为AP、GPU等以运算效能为优先的晶片封装。
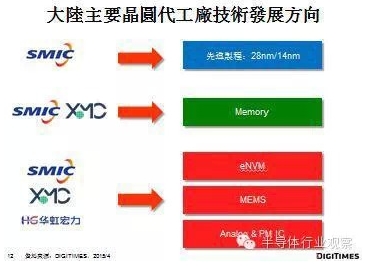
与台积电、Intel、Globalfoundries等国际级晶圆代工大厂相较,大陆晶圆代工业者于微缩製程技术水准仍有相当一段差距,至2015年上半,仅有中芯国际跨入28奈米製程,并有能力向14奈米製程持续发展。
DIGITIMES Research预期,在十三五规划期间,提高大陆半导体市场自给率,强化半导体产业链将会是重要产业政策目标,这也让给发展记忆体产业将会成为重要方向,也因此2015年3月上海武岳峰资本以6.4亿美元收购美国记忆体厂商ISSI可以视为大陆正式进军记忆体产业的第一步。除此之外,在大陆政府的指示下,包括中芯国际、武汉新芯都将NAND Flash投入研发并规划量产,武汉新芯更对次世代记忆体RRAM与MRAM投入研发,目的就是希望能够在大陆自主生产记忆体。
除AP、Baseband、RF、蓝芽等晶片外,包括MCU、CIS、NFC等IoT应用主要晶片所需最先进製程也仅达65/55奈米製程,事实上,0.13/0.11微米才是其中主流,MEMS、指纹辨视等特殊製程所需最先进製程更仅有0.18微米,对于仅有8吋厂大陆晶圆代工业者而言,往特殊製程方向投入研发为必然发展方向。著眼于IoT未来庞大商机,包括中芯国际与武汉新芯也朝特殊製程投入研发。综合中芯国际、武汉新芯、华虹宏力等大陆主要晶圆代工厂于特殊製程发展方向,eNVM、MEMS、Analog & PM IC将是特殊製程的重要技术领域。
然而,在客製化程度高的IoT市场中,如何能够做到少量多样,并提供低成本的解决方案,将会是重要问题之一,而在异质整合与模组化的要求下,如何结合IC设计客户与封测业者提供完整解决方案,恐怕更是关键之所在。